장비안내
Si BEOL & GaN MPW
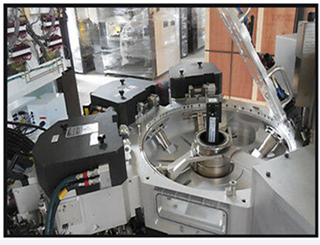
- 장비아이디 FS-PE10
- 장비명 HDP-CVD(고밀도플라즈마 화학기상증착기)
- Model Centura5200 Ultima/DxZ
- Maker APPLIED MATERIALS
- 담당자 박성민
- 연락처 031-546-6232
- E-Mail sungmin.park@kanc.re.kr
- 상 태 ● (가동중)
적용가능한 기판 정보
O (가능) / △ (협의필요) / X (불가능)
| 기판 종류 | 기판 Size | 기판 Type | 기판 두께 | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | III-V | Glass | Flex | 조각 | 2" | 4" | 6" | 8" | 12" | 플랫 | 노치 | Normal | Special |
| O | X | X | X | X | X | X | X | O | X | △ | O | O | X |
장비사양(Hardware Specification)
General Information
ㆍ Wafer Specification
- Wafer Size : 200mm
- Wafer Shape : SNNF (Semi Notch No Flat)
ㆍ Platform Type : Centura 5200 (HDP Ultima + DxZ)
- HDP Process Chamber
- Dxz Process Chamber
- Multi slot Cool-down Chamber
- Oriental Chamber
- Left/Right Load-lock Chamber
공정성능(Process Specification)
ㆍ Process : IMD Deposition (USG)
- Dep-Etch-Dep Method
- Deposition thickness : up to 2㎛
- Wafer Temperature : 370~500℃
- Deposition Rate : 4000±400A/min
- Refractive Index : 1.460±0.01 (@ THK:1000A, 파장: 632nm)
- Gap-fill : Pattern Wafer Void Free
- Uniformity <±5% (within wafer thickness(@49 points, EE 5mm) & wafer-to-wafer (@ 5wafers)
ㆍ Process : IMD Deposition (FSG)
- Dep Rate : 3000±300A/min
- Sputter Rate : 1300±200A/min
- Film Uniformity : ≤ ±5%
(within wafer thickness(@41 points, EE 5mm) & wafer-to-wafer (@ 5wafers)
- Refractive Index : 1.44±0.01 (@ THK:1000A, 파장: 632nm)
- Gap-fill : Pattern Wafer Void Free
- F concentration : 4.0±1.0wt%(@ Film THK:6000A)
활용분야(Application)
ㆍ Insulator Layer Deposition for semiconductor
- IMD(Inter Metal Dielectric Deposition (FSG & USG)
- Passivation Deposition (SiO2 & Nitride)

